阿达电子公司资 从制造商的立场来看,除非实现硅穿孔(TSV)所增加的成本以及随之而来的所有工艺步骤都能够因为芯片性能优势而得到大部分的补偿,或是工艺与材料成本大幅降低,才可能加速3D IC的量产。
因此,在今年初于法国举行的欧洲3D TSV高峰会上,提到一个重要的问题是,如何才能将拥有成本平均分配到整个供应链?
该由谁来制造TSV?
针对非MEMS IC,TSV也必须进一步微缩,这是因为如果你的TSV“排除区域”(Keep-out zone)耗用太多优质芯片面积的话,进展到下一代节点也并不一定有意义。由于这些工艺需要的设备组合通常只在晶圆厂中才有,因此TSV的整合理想上应该由代工厂来完成,不过委外半导体组装与测试(OSAT)服务供货商也有机会在某种程度上参与。此外,有些电路板(PCB)制造商也考虑在PCB基板中嵌入芯片,以主动硅中介层的形式实现2.5D整合。
针对较大的CoWoS组件,台积电已在60×60mm的基板上展示了26×48mm的硅中介层。该公司表示在28nm逻辑芯片上堆栈内存已经准备就绪,也为客户的测试载具设计与功能性验证规划了TSV设计规则。
Global Foundries负责封装技术研发的Michael Thiele透露,该公司已在纽约州Malta的Fab 8厂安装好TSV产线了,能以TSV为20nm器件以及未来的14nm器件特性进行整合。该公司同时也在其于新加坡的Fab 7厂安装300mm TSV产线,用于制造硅中介层,以及在德国Dresden的Fab 1厂增加以TSV整合28nm器件特性。
“在考虑2.5D产品量产时,客户通常期望代工厂能提出具代表性的测试载具及其所提供的系统级量化数据,”因此,Thiele表示Global Foundries为此采取双管齐下的途径,一方面利用可共享研发细节的外部测试载具,另一方面也建立自家的内部测试载具。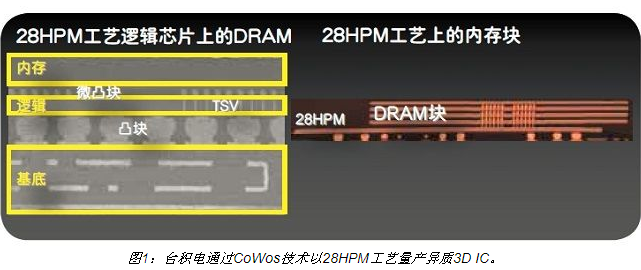
因此,该公司同时透过OSAT合作伙伴以及自家公司内部开发硅中介层与微柱互连。但是,Thiele强调,良率不足以及供应链延迟,都可能中止该技术应用,特别是如果未能在供应链中清楚定义出产量的所有权分配。针对雷射钻孔与填充TSV穿孔、暂时性晶圆键合与去键合,以及硅穿孔露出等关键制程步骤进一步降低成本,是3D IC得以落实大众市场的另一个必备条件。
除了当前经济环境可能限制TSV在短期内量产,市调公司Gartner首席产业分析师Mark Stromberg预期,TSV市场还将面临资金成本议题,从而限制了有能力建置这项技术的业者数量。这主要来自于增加的资本与材料成本,以及越来越多的工艺步骤。“在过渡到10nm节点时,系统设计将需要利用TSV技术,”不过,Stromberg强调,届时将会因为需要的庞大资本支出而减缓市场上仅存几家主导IDM、代工厂以及一线半导体封装测试服务(SATS)供货商之间的市场竞争。
Silver进一步指出:“在代工厂、OSAT和IDM竞相抢占510亿美元的芯片组装与测试市场之际,预计未来将会看到更多的并购发生。随着封装技术变得越来越先进,特别是在晶圆级,前端工艺与后端封装之间将会发生重新整并与融合。”
台积电(TSMC)泛欧地区(EMEA)副总裁Miekei Ieong介绍该公司的CoWoS(芯片-晶圆-基板)整合型芯片服务,利用次微米级硅中介层以TSV技术将多个芯片整合于单一封装中。该公司可提供CoWoS量产同质组件,并表示已经展示了异质CoWoS。该512bit Wide I/O DRAM测试芯片作业于200MHz核心频率,在全速作业模式时甚至可过载高达285MHz。
“我们的1024bit CoWoS DRAM可驱动至1GHz,支持达128GB/s的频带,”Ieong表示,该公司并计划在今年第四季以前量产菊链式连接6颗芯片的高带宽内存。讯:IC成本在TSV技术的影响下 效益提升
原发布时间:2015-4-7 11:36:40






